晶圆加工工艺中减小翘曲度的方法与流程
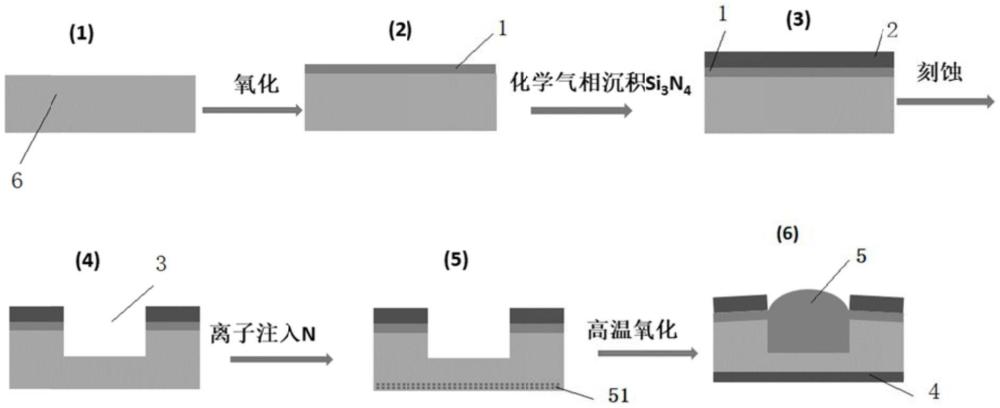
本发明属于半导体,尤其涉及一种晶圆加工工艺中减小翘曲度的方法。
背景技术:
1、在半导体制造领域,器件隔离技术是确保集成电路中各元件彼此电气绝缘的关键工艺。传统的器件隔离方法存在诸多挑战,如复杂的制造流程和潜在的器件性能影响。locos(硅的选择氧化)工艺作为一种经典的器件隔离技术,因其有效的隔离性能和较高的制造成熟度,被广泛应用于半导体器件的制造中。
2、locos工艺利用硅选择氧化的原理,在氮化硅掩膜的保护下,实现了深槽(槽深大于0.5微米)区域的硅选择性氧化。通过光刻和刻蚀工艺在氮化硅层上开槽,在开槽区域内形成locos结构。
3、locos工艺的核心优势在于其简单高效的隔离效果。利用sio2的电绝缘特性,locos工艺可以在器件之间形成可靠的电气隔离,同时减少相邻器件间的干扰。然而,locos工艺也面临一些挑战。例如,氮化硅沉积过程中和locos工艺生长过程中可能引入的应力会导致硅片的形变(warpage),影响后续工艺步骤和器件性能。
技术实现思路
1、针对相关技术中存在的不足之处,本发明提供了一种晶圆加工工艺中减小翘曲度的方法,解决晶圆加工过程中翘曲的问题。
2、在一种可能的实施方式中,提供了一种晶圆加工工艺中减小翘曲度的方法,包括以下步骤:对晶圆正面进行氧化,形成第一氧化层(sio2);在晶圆正面的氧化层上,通过化学气相沉积工艺沉积顶部氮化硅层;在晶圆正面刻蚀凹槽;对晶圆进行高温氧化,使凹槽内形成第二氧化层(locos);还包括:在对晶圆进行高温氧化,使凹槽内形成第二氧化层之前,对晶圆背面通过高剂量离子注入法注入氮元素;以使得在对晶圆进行高温氧化时,晶圆背面形成底部氮化硅层。
3、在一种可能的实施方式中,在晶圆背面通过高剂量离子注入法注入氮元素,注入剂量为大于1e16/cm2。
4、在一种可能的实施方式中,在1100℃的温度下,对晶圆进行高温氧化。
5、在一种可能的实施方式中,在晶圆正面刻蚀凹槽后,对晶圆背面通过高剂量离子注入法注入氮元素。
6、在一种可能的实施方式中,通过化学气相沉积(pecvd)沉积顶部氮化硅层在温度400℃、总气体压力2-3torr、沉积功率1kw的条件下进行。
7、在一种可能的实施方式中,顶部氮化硅层的厚度为1000a-2000a。
8、在一种可能的实施方式中,晶圆背面注入氮元素的重复次数为2至3次。
9、基于上述技术方案,本发明的晶圆加工工艺中减小翘曲度的方法,通过对晶圆正面进行氧化形成第一氧化层,并在其上沉积顶部氮化硅层,然后刻蚀凹槽并进行高温氧化,在高温氧化前对晶圆背面注入氮元素,以使得在高温氧化时,凹槽内形成第二氧化层的同时,背面形成底部氮化硅层,从而避免oxide在背面的生长,平衡凹槽内形成第二氧化层时产生的应力,改善了晶圆加工过程中翘曲的问题。
技术特征:
1.一种晶圆加工工艺中减小翘曲度的方法,其特征在于,包括以下步骤:
2.根据权利要求1的晶圆加工工艺中减小翘曲度的方法,其特征在于,在晶圆背面通过高剂量离子注入法注入氮元素,注入剂量为大于1e16/cm2。
3.根据权利要求2的晶圆加工工艺中减小翘曲度的方法,其特征在于,在1100℃的温度下,对晶圆进行高温氧化。
4.根据权利要求3的晶圆加工工艺中减小翘曲度的方法,其特征在于,在晶圆正面刻蚀凹槽后,对晶圆背面通过高剂量离子注入法注入氮元素。
5.根据权利要求4的晶圆加工工艺中减小翘曲度的方法,其特征在于,通过化学气相沉积(pecvd)沉积顶部氮化硅层在温度400℃、总气体压力2-3torr、沉积功率1kw的条件下进行。
6.根据权利要求5的晶圆加工工艺中减小翘曲度的方法,其特征在于,顶部氮化硅层的厚度为1000a-2000a。
7.根据权利要求6的晶圆加工工艺中减小翘曲度的方法,其特征在于,晶圆背面注入氮元素的重复次数为2至3次。
技术总结
本发明涉及一种晶圆加工工艺中减小翘曲度的方法,包括以下步骤:对晶圆正面进行氧化,形成第一氧化层;在晶圆正面的氧化层上,通过化学气相沉积工艺沉积顶部氮化硅层;在晶圆正面刻蚀凹槽;对晶圆进行高温氧化,使凹槽内形成第二氧化层;在对晶圆进行高温氧化,使凹槽内形成第二氧化层之前,对晶圆背面通过高剂量离子注入法注入氮元素,以使得在对晶圆进行高温氧化时,晶圆背面形成底部氮化硅层。本发明解决了晶圆加工过程中翘曲度的技术问题。
技术研发人员:张甍,曹学文,李亨,颜天才,杨列勇
受保护的技术使用者:物元半导体技术(青岛)有限公司
技术研发日:
技术公布日:2024/11/14
技术研发人员:张甍,曹学文,李亨,颜天才,杨列勇
技术所有人:物元半导体技术(青岛)有限公司
备 注:该技术已申请专利,仅供学习研究,如用于商业用途,请联系技术所有人。
声 明 :此信息收集于网络,如果你是此专利的发明人不想本网站收录此信息请联系我们,我们会在第一时间删除
